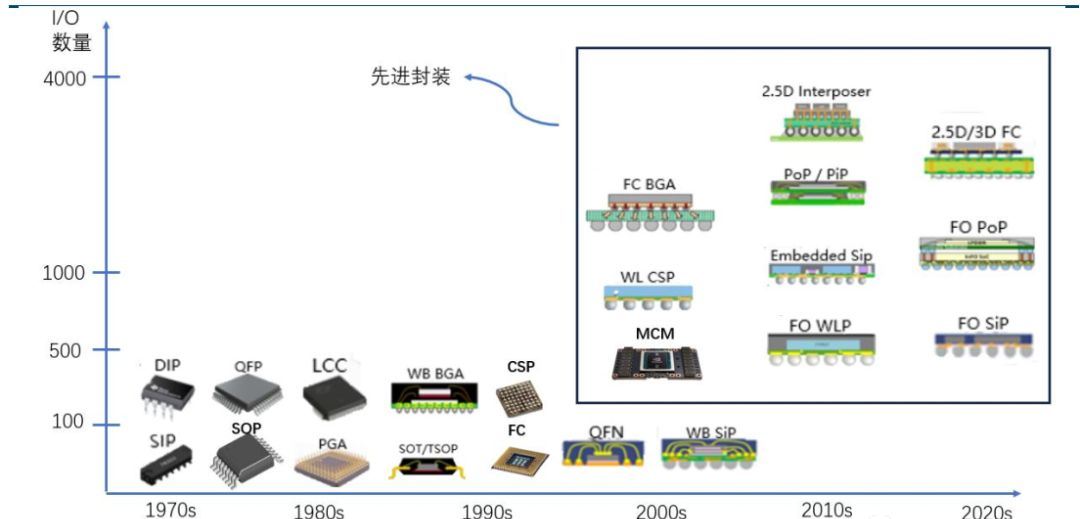
souce:国金证券
先进封装的增长趋势
随着芯片功能和性能的不断提高,对先进封装的需求也在不断增加。在某些领域,如高性能计算、人工智能、物联网等,先进封装的市场占比已经非常高。
根据Yole Intelligence的预测,到2025年,先进封装的收入将超过传统封装。同时,表示目前先进封装的主要应用领域集中在消费电子,但未来该技术在电信基建与汽车电子领域的应用增速会显著加快。就其内部技术而言,增长率最高的细分预期会是嵌入式晶片、2.5D/3D,以及倒装芯片。这表明先进封装市场具有巨大的潜力和发展空间。

souce:Yole Group
现阶段的先进封装技术主要包括倒装焊(FlipChip)、晶圆级封装(WLP)、2.5D/3D封装、系统级封装(SiP)等。
◎ 倒装焊(FlipChip)

◎ 晶圆级封装(WLP)
晶圆级封装(WLP)是一种将多个芯片集成在一个封装内的封装方式,可以实现高密度、高性能的封装。随着市场对高性能计算和存储器等产品的需求不断增加,晶圆级封装的应用也将越来越广泛。未来,晶圆级封装将继续朝着更高速、更可靠、更小型化的方向发展。
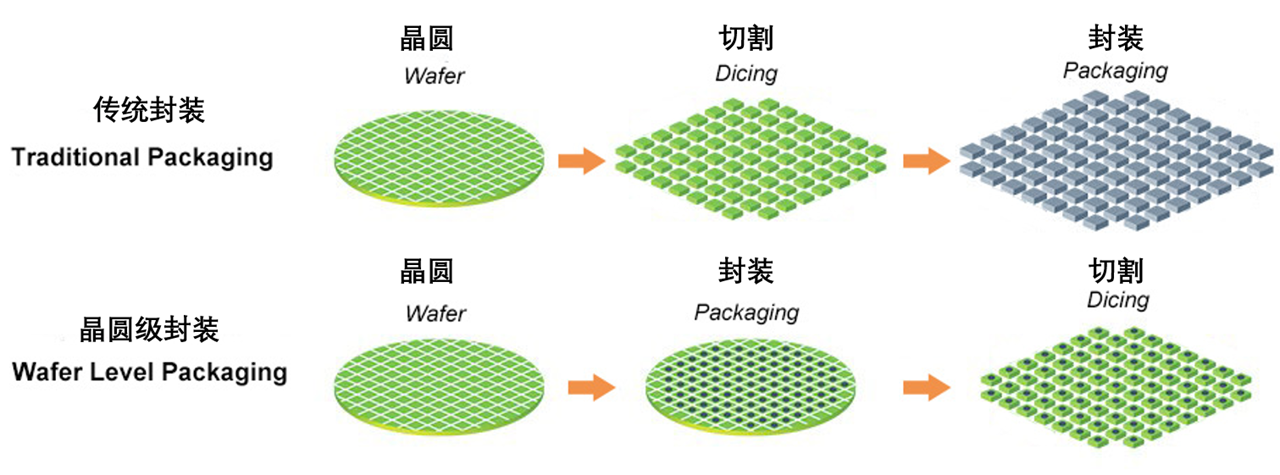
◎ 2.5D封装(Interposer、RDL)
2.5D封装(Interposer、RDL)是一种通过中介层实现芯片与芯片之间的连接的封装方式,可以实现高密度、高性能的封装。随着市场对高性能计算和存储器等产品的需求不断增加,2.5D封装的应用也将越来越广泛。未来,2.5D封装将继续朝着更高速、更可靠、更小型化的方向发展。
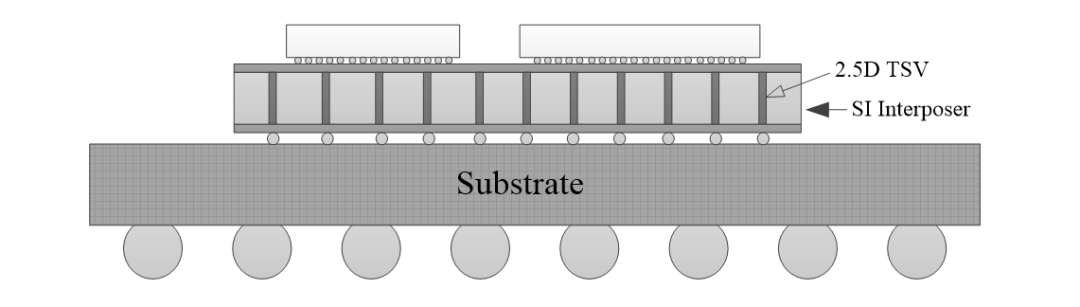 ◎ 3D封装(TSV)
◎ 3D封装(TSV)
3D封装(TSV)是一种将多个芯片垂直堆叠在一起,通过TSV等方式实现芯片与芯片之间的连接的封装方式。随着市场对高性能计算和存储器等产品的需求不断增加,3D封装的应用也将越来越广泛。未来,3D封装将继续朝着更高速、更可靠、更小型化的方向发展。
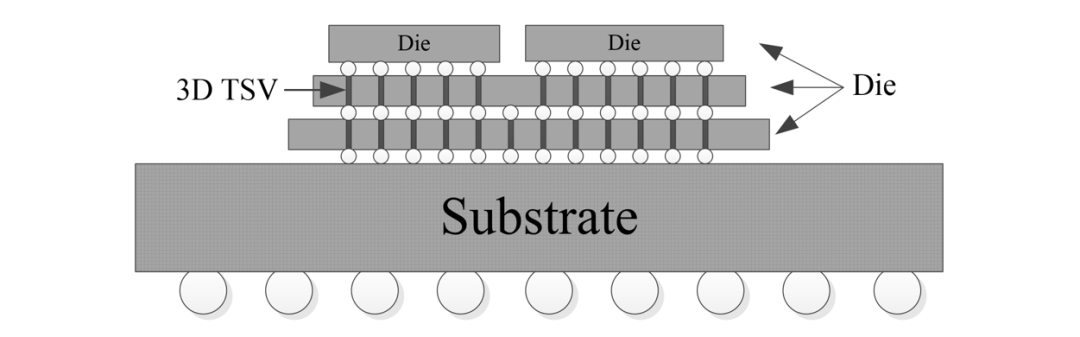
◎ 系统级封装(SiP)
系统级封装(SiP)是将多个集成电路(IC)或小芯片(Chiplets)集成在一个封装模块内,形成一个完整的功能性系统。这些小芯片可以包括各种组件,例如处理器、存储器、射频 (RF) 收发器和电源管理 IC 在封装内互连。这种高集成度允许将完整的功能系统包含在单个封装内,使 SiP 成为节省空间的解决方案,非常适合外形尺寸和集成度至关重要的应用,例如移动设备和可穿戴设备。SiP 还在设计和制造方面提供了显着的灵活性,因为每个小芯片都可以使用最适合其功能的工艺技术来制造。
Chiplet技术是异构集成理念下的一项关键实践。依据Yole的定义,Chiplet设计方法涉及将两个或多个独立的小芯片以分解的系统级封装(SiP)的形式组合在一起。小芯片的功能涵盖典型处理器 SoC 中的基本知识产权 (IP) 块,包括中央处理单元 (CPU)、图形处理单元 (GPU)、神经处理单元 (NPU)、I/O 和内存控制器以及接口、高速缓存存储器和模拟功能(SerDes、PLL、DAC、ADC、PHY 等)。
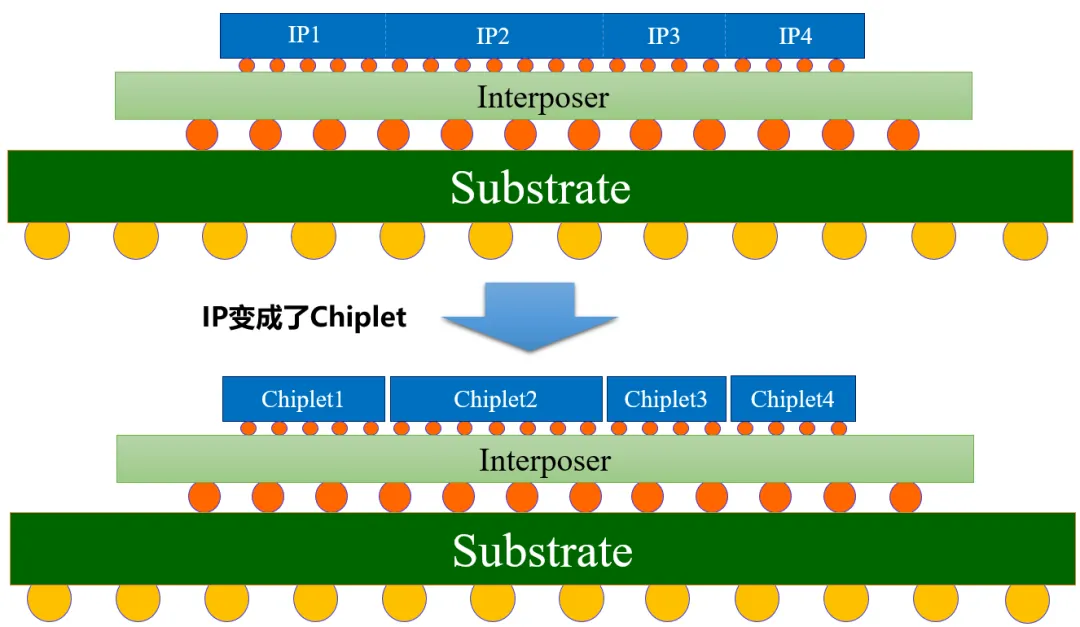
受益于先进封装Chiplet产业的趋势发展,后道封装设备产业也进一步拓宽。固晶机是封装工艺中占比较高的设备,在先进封装制造中扮演着重要的角色。在先进封装过程中,固晶机将芯片从已经切割好的晶圆上抓取下来,并安置在基板对应的Die flag上,利用银胶(Epoxy)或锡膏等材料把芯片和基板粘接起来。
固晶贴片机具有高精度、高速度的特点,能够实现自动化、大规模的生产。在先进封装制造中,固晶机是实现芯片与基板之间精密对位和牢固结合的关键设备之一。随着先进封装技术的快速发展,固晶机需要具备更精准的定位、更稳定的运动控制、更强大的粘附系统,才能满足先进封装工艺精密可靠的执行要求。
博众半导体研发的星驰系列高速高精度固晶贴片机完美契合先进封装工艺。通过自研的运动控制技术,满足±10μm@3σ的高贴片精度,可实现3000pcs/h的极致贴片效率(依据具体工艺制程)。DU9721系列产品采用开放式架构和模块化设计,为客户提供极致效率的按需定制能力。通过集成点胶、自动换刀、热压贴合等功能,可处理多尺寸晶圆,实现多种基板传送方式,满足固晶,Flip chip,SiP等多种先进封装工艺。

不同的封装工艺和材料对固晶机的性能要求也会有所差异,因此固晶机需要具备更高的可配置性和适应性。未来,高精度、高效性、多元化、定制化、智能化、环保和可持续发展是固晶机发展的必然趋势,让我们期待着固晶机在未来为先进封装技术的发展带来更多的创新和突破!














